BGA(Ball Grid Array)返修焊接是一種用于修復或重新連接BGA芯片(Ball Grid Array chip)的焊接過程。BGA芯片通常具有許多小球狀連接點,這些連接點位于芯片的底部,通過它們與電路板上的焊盤連接。
返修焊接可能需要在BGA芯片或電路板上重新焊接某些連接點,可能是由于原始焊接不良、連接點斷裂、芯片移位或其他問題。這項工作需要的設備和技術,因為BGA芯片的連接點非常小且密集,要求和熟練的操作。
通常的BGA返修焊接過程包括以下步驟:
1. 去除原有的BGA芯片:使用熱空氣槍或熱風槍將原有的BGA芯片從電路板上去除。
2. 清理焊盤:清除原有焊料和殘留物,確保焊盤表面干凈。
3. 準備新的BGA芯片:檢查新的BGA芯片,確保它沒有缺陷,并根據需要進行預處理(如球形化)。
4. 定位新的BGA芯片:將新的BGA芯片準確地放置在焊盤上,并確保它與電路板對齊。
5. 焊接新的BGA芯片:使用適當的焊接工具和技術,對BGA芯片進行焊接。這可能涉及到使用熱風槍、紅外加熱或其他方法來加熱整個BGA芯片,使焊料融化并形成可靠的連接。
6. 檢查和測試:對焊接完成的BGA芯片進行檢查和測試,確保連接質量良好并且沒有短路或其他問題。
BGA返修焊接需要經驗豐富的技術人員進行操作,以確保成功完成并且不會對電路板或芯片造成損壞。
BGA芯片(Ball Grid Array)是一種集成電路封裝技術,其特點是在芯片底部焊接了一排小球形引腳。這些引腳以網格狀排列,與印刷電路板上的焊接點相匹配。BGA芯片相比傳統的封裝形式具有更高的密度和更好的散熱性能,因此在現代電子產品中得到廣泛應用,尤其是在計算機、通信設備和消費電子產品中。
QFP(Quad Flat Package)芯片是一種集成電路封裝形式,通常用于集成電路的表面安裝。它的外形是一個方形或矩形的塑料封裝,有四個側面引出引腳。這些引腳排列在封裝的四周,使得焊接和連接變得相對容易。QFP芯片通常用于中等至高密度的集成電路,例如微處理器、微控制器、FPGA等。它們提供了一種、高密度、相對低成本的封裝解決方案,適用于各種電子設備和應用。

恒溫加熱臺加熱平臺加熱返修平臺高溫加熱臺。
1元
產品名:返修臺,加熱臺,恒溫臺,加熱平臺

BGAQFNQFP廢舊芯片翻新加工重新植球清洗包裝
1元
產品名:smt貼片,dip插件,qfn清洗,bga磨平
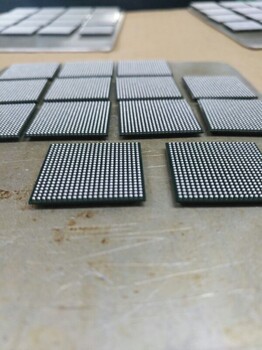
IC芯片翻新芯片拆卸BGA植球BGA焊接返修更換
1元
產品名:smt貼片,dip插件,qfn清洗,bga磨平

SOP8SOP16TSOP芯片編帶加工BGA除錫除氧化植球
1元
產品名:BGA編帶,QFP編帶,QFN編帶,SOP編帶
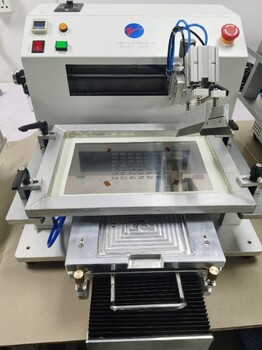
QFN清洗QFN編帶包裝QFN返修QFN焊接SMT貼片
1元
產品名:smt貼片,dip插件,qfn清洗,bga磨平

BGA植球BGA返修焊接QFN去錫磨平
1元
產品名:bga換料,qfp焊接,qfn磨平,cpu植球
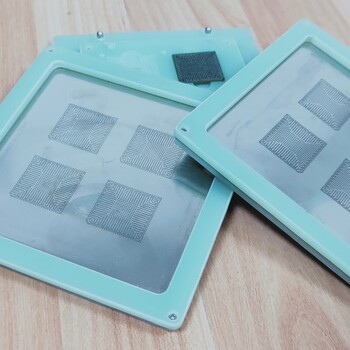
龍芯BGA芯片植球返修焊接龍芯CPU
面議
產品名:龍芯CPU
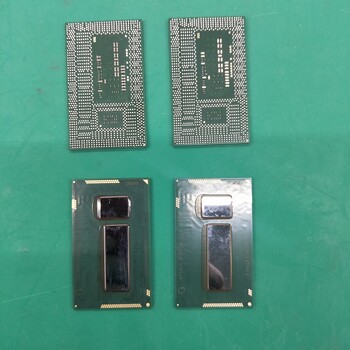
筆記本cpu芯片拆卸除錫植球
面議
產品名:bga芯片植球