傳統的芯片粘接和基板粘接材料通常由焊料合金組成,其粘結層厚度范圍為50至100μm(用于芯片連接)和100至150μm(用于基板連接)。盡管性能還不錯,但在特斯拉、比亞迪和現代等主要汽車原始設備制造商的推動下,人們對無壓燒結銀的偏好越來越高。
與傳統的焊料合金相比,燒結銀AS9378具有更高的導熱性(200至300W/mK),有可能將從結到外殼的熱阻降低40%以上,同時顯著提高熔點并降低電阻率。此外根據下表數據可觀察到銀燒結的高使用溫度接近900℃遠超傳統焊料。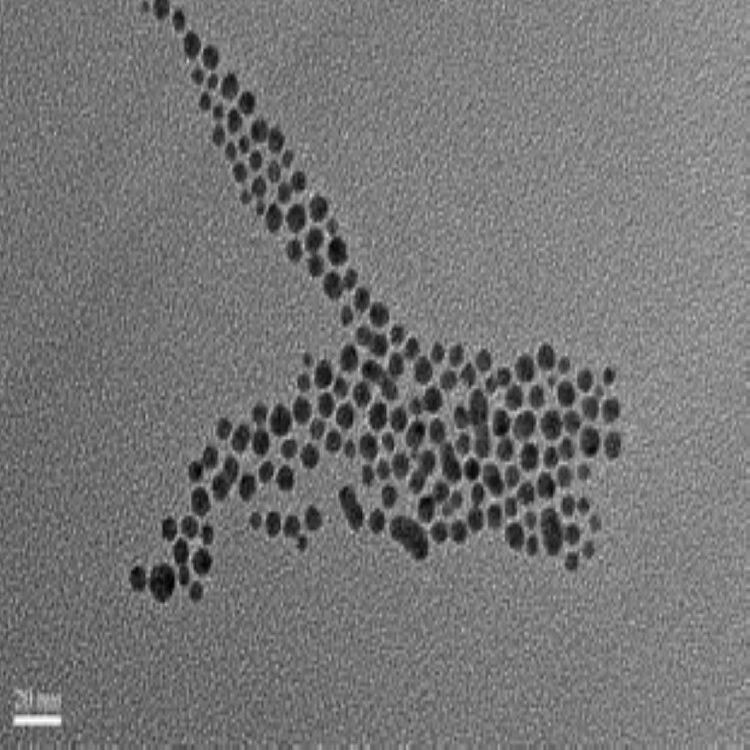
在功率器件中,流經焊接處的熱量非常高,因此需要更加注意芯片與框架連接處的熱性能及其處理高溫而不降低性能的能力。善仁新材的燒結銀的熱阻要比焊料低得多,因而使用燒結銀代替焊料能提高RθJC,而且由于銀的熔點較高,整個設計的熱裕度也提高了。
善仁新材燒結材料通常可以達到200℃-300℃,這讓燒結技術成為焊接工藝理想的替代方案。此外,芯片粘接是一個極其復雜的過程,采用燒結銀技術進行芯片粘接,可大大降低總制造成本,加工后無需清洗,還可縮短芯片之間的距離。
大功率LED封裝?:善仁燒結銀漿(AS9300系列)中的燒結銀漿(AS9331、AS9332)用于高功率LED的封裝,提高LED的發光效率和壽命。
善仁燒結銀在提高電子設備性能、降低成本、增強可靠性和促進規模化生產方面的重要作用。通過不斷創新和應用,善仁燒結銀技術正在推動電子行業的發展,滿足日益增長的市場需求?
