燒結銀AS9376燒結銀的導電率? ≥1×10? S/cm(燒結后) 支持高密度互連(電阻率低至1.6 μΩ·cm)
?熱膨脹系數(CTE)?? 可定制(≈5-8 ppm/℃) 匹配硅/陶瓷基板(ΔCTE <5 ppm/℃)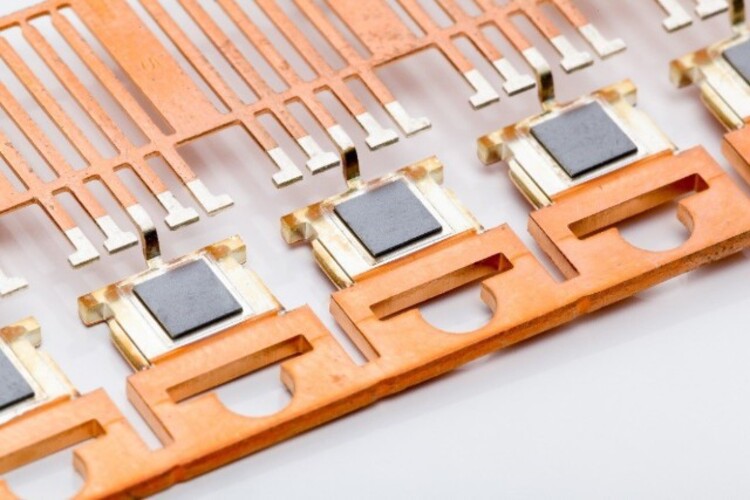
燒結銀AS9376的技術優勢總結
?工藝自由度:
AS9376無需外部壓力,適配現有光刻、絲網印刷等HPC產線工藝。
?性能平衡:
導電率與熱導率(≥600 W/m·K)兼顧,支持高頻高速信號傳輸與散熱。
燒結銀AS9376的長期穩定性:
抗離子遷移設計(添加Al?O?納米顆粒)使85℃/85%RH下電阻漂移率<5%/1000小時。
?成本效益:
銀包銅替代方案(Cu含量≤10%)可降低銀用量30%,材料成本下降25%。
燒結銀AS9376實施建議與驗證方法
?燒結曲線設計:
推薦兩段式工藝:150℃預燒結(5 min)+峰值溫度180℃(3℃/s升溫,10 min保溫)。
燒結銀AS9375的可靠性測試:
PCT測試(100 bar/85℃)評估體積變化率(ΔV/V <0.5%)。
高溫加速老化(85℃/85%RH/1000小時)監測電阻漂移率。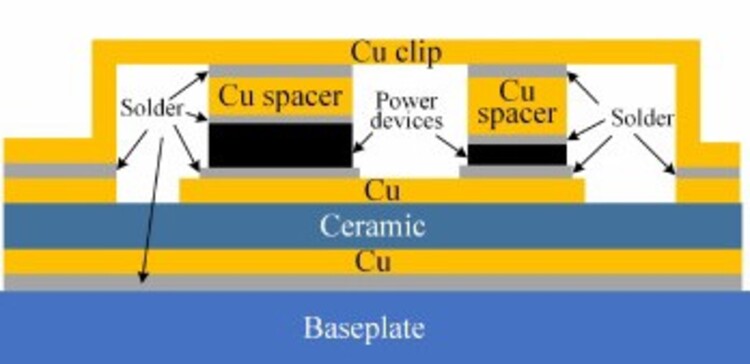
燒結銀AS9376的未來擴展方向
?異質集成:
結合ALD銀膜(厚度~0.3 nm)構建三維互連網絡,實現低電阻(<10?? Ω·cm2)。
?智能化材料:
引入形狀記憶聚合物(SMP)改性銀漿,實現微裂紋自修復(修復效率>90%)。
