眾所周知,在單管封裝中,影響器件Rth(j-c)熱阻的主要是芯片、焊料和基板。SiC芯片材料的導熱率為370W/(m.K),遠IGBT的Si(124W/(m.K)),甚至超過金屬鋁(220W/(m.K)),與Lead Frame的銅(390 W/(m.K))非常接近。而一般焊料的導熱率才60 W/(m.K)左右,典型厚度在50-100um,所占整個器件內部Rth(j-c)熱阻之權重,是不言而喻的。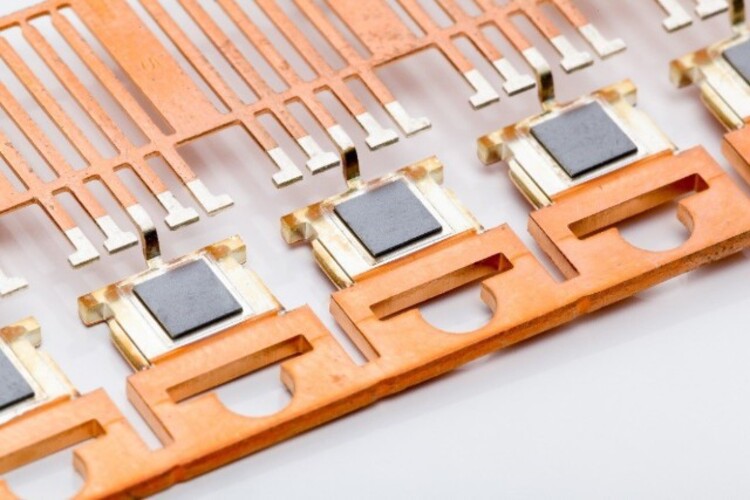
功率半導體是電子裝置中電能轉換與電路控制的核心,主要用于改變電子裝置中電壓和頻率、直流交流轉換等。可分為功率IC和功率分立器件兩大類,二者集成為功率模塊(包含MOSFET/IGBT模塊、IPM模塊、PIM模塊)。隨著電力電子模塊的功率密度、工作溫度及其對可靠性的要求越來越高,當前的封裝材料已經達到了應用極限。
善仁新材的GVF9700無壓預燒結焊盤和GVF9800有壓預燒結焊盤,為客戶帶來多重便利,包括無需印刷、點膠或干燥,GVF預燒結銀焊片工藝(DTS+TCB(Die Top System +Thick Cu Bonding)可以將銅鍵合線和燒結工藝很好結合在一起,同時具有較高的靈活性,可以同時讓多個鍵合線連接在預燒結焊盤上來進行頂部連接。
使用了GVF預燒結銀焊片使器件結溫可以超過200°C。因此,GVF預燒結銀焊片可以大幅降低功率限額,或者在確保電流相同的情況下縮小芯片尺寸,從而降低電力成本。
SHAREX的預燒結銀焊片GVF9800(DTS+TCB(Die Top System +Thick Cu Bonding)是結合了燒結銀,銅箔和其他材料的一種復合材料,由以下四個部分組成:具有鍵合功能的銅箔;預涂布AS9385系列燒結銀;燒結前可選用臨時固定的膠粘劑;保護膜或者承載物。
GVF預燒結銀焊片(DTS+TCB(Die Top System +Thick Cu Bonding)和金,銀,銅表面剪切強度都很大。
